集成电路(英语:integrated circuit,缩写作 IC;德语:integrierter Schaltkreis),或称微电路(microcircuit)、微芯片(microchip)、芯片(chip),在电子学中是一种将电路(主要包括半导体设备,也包括被动组件等)集中制造在半导体晶圆表面上的小型化方式。
前述将电路制造在半导体芯片表面上的集成电路,又称薄膜(thin-film)集成电路。另有一种厚膜(thick-film)集成电路(hybrid integrated circuit)是由独立半导体设备和被动组件集成到衬底或线路板所构成的小型化电路
介绍
晶体管发明并大量生产之后,各式固态半导体组件如二极管、晶体管等大量使用,取代了真空管在电路中的功能与角色。到了20世纪中后期半导体制造技术进步,便使集成电路成为可能。相对于手工组装电路使用个别的分立电子组件,集成电路可以把很大数量的微晶体管集成到一个小芯片,是一个巨大的进步。集成电路的规模生产能力、可靠性,电路设计的模块化方法确保了快速采用标准化集成电路代替了设计使用离散晶体管。
集成电路对于离散晶体管有两个主要优势:成本和性能。成本低是由于芯片把所有的组件通过照相平版技术,作为一个单位印刷,而不是在一个时间只制作一个晶体管。性能高是由于组件快速开关,消耗更低能量,因为组件很小且彼此靠近。2006年,芯片面积从几平方毫米到350 mm²,每mm²可以达到一百万个晶体管。
第一个集成电路雏形是由杰克·基尔比于1958年完成的,其中包括一个双极性晶体管,三个电阻和一个电容器,相较于现今科技的尺寸来讲,体积相当庞大。

根据一个芯片上集成的微电子器件的数量,集成电路可以分为以下几类:
- 小型集成电路(SSI英文全名为Small Scale Integration)逻辑门10个以下或 晶体管100个以下。
- 中型集成电路(MSI英文全名为Medium Scale Integration)逻辑门11~100个或 晶体管101~1k个。
- 大规模集成电路(LSI英文全名为Large Scale Integration)逻辑门101~1k个或 晶体管1,001~10k个。
- 超大规模集成电路(VLSI英文全名为Very large scale integration)逻辑门1,001~10k个或 晶体管10,001~100k个。
- 极大规模集成电路(ULSI英文全名为Ultra Large Scale Integration)逻辑门10,001~1M个或 晶体管100,001~10M个。
- GSI(英文全名为Giga Scale Integration)逻辑门1,000,001个以上或晶体管10,000,001个以上。
而根据处理信号的不同,可以分为模拟集成电路、数字集成电路、和兼具模拟与数字的混合信号集成电路。
集成电路的发展
最先进的集成电路是微处理器或多核处理器的核心,可以控制一切电路,从数字微波炉、手机到电脑。存储器和特定应用集成电路是其他集成电路家族的例子,对于现代信息社会非常重要。虽然设计开发一个复杂集成电路的成本非常高,但是当成本分散到数以百万计的产品上时,每个集成电路的成本便能最小化。集成电路的性能很高,因为小尺寸带来短路径,使得低功率逻辑电路可以在快速开关速度应用。
这些年来,集成电路持续向更小的外型尺寸发展,使得每个芯片可以封装更多的电路。这样增加了每单位面积容量,可以降低成本和增加功能-见摩尔定律,集成电路中的晶体管数量,每1.5年增加一倍。总之,随着外形尺寸缩小,几乎所有的指标改善了-单位成本和开关功率消耗下降,速度提高。但是,集成纳米级别设备的IC不是没有问题,主要是泄漏电流。因此,对于最终用户的速度和功率消耗增加非常明显,制造商面临使用更好几何学的尖锐挑战。这个过程和在未来几年所期望的进步,在半导体国际技术路线图中有很好的描述。
集成电路的普及
仅仅在其开发后半个世纪,集成电路变得无处不在,电脑、手机和其他数字电器成为现代社会结构不可缺少的一部分。这是因为,现代计算、交流、制造和交通系统,包括互联网,全都依赖于集成电路的存在。甚至有很多学者认为集成电路带来的数字革命是人类历史中最重要的事件。IC的成熟将会带来科技的大跃进,不论是在设计的技术上,或是半导体的工艺突破,两者都是息息相关。
集成电路的分类
加以颜色标示的集成电路内部单元构成实例,四层铜平面作电路连接,之下是多晶硅(粉红)、阱(灰)、与基片(绿)
集成电路的分类方法很多,依照电路属模拟或数字,可以分为:模拟集成电路、数字集成电路和混合信号集成电路(模拟和数字在一个芯片上)。
数字集成电路可以包含任何东西,在几平方毫米上有从几千到百万的逻辑门、触发器、多任务器和其他电路。这些电路的小尺寸使得与板级集成相比,有更高速度,更低功耗(参见低功耗设计)并降低了制造成本。这些数字IC,以微处理器、数字信号处理器和微控制器为代表,工作中使用二进制,处理1和0信号。
模拟集成电路有,例如传感器、电源控制电路和运放,处理模拟信号。完成放大、滤波、解调、混频的功能等。通过使用专家所设计、具有良好特性的模拟集成电路,减轻了电路设计师的重担,不需凡事再由基础的一个个晶体管处设计起。
集成电路可以把模拟和数字电路集成在一个单芯片上,以做出如模拟数字转换器和数字模拟转换器等器件。这种电路提供更小的尺寸和更低的成本,但是对于信号冲突必须小心。
集成电路的制造
从1930年代开始,元素周期表中的化学元素中的半导体被研究者如贝尔实验室的威廉·肖克利(William Shockley)认为是固态真空管的最可能的原料。从氧化铜到锗,再到硅,原料在1940到1950年代被系统的研究。今天,尽管元素周期表中的一些III-V价化合物如砷化镓应用于特殊用途如:发光二极管、激光、太阳能电池和最高速集成电路,单晶硅成为集成电路主流的基层。创造无缺陷晶体的方法用去了数十年的时间。
半导体集成电路工艺,包括以下步骤,并重复使用:
- 光刻
- 刻蚀
- 薄膜(化学气相沉积或物理气相沉积)
- 掺杂(热扩散或离子注入)
- 化学机械平坦化CMP
使用单晶硅晶圆(或III-V族,如砷化镓)用作基层,然后使用光刻、掺杂、CMP等技术制成MOSFET或BJT等组件,再利用薄膜和CMP技术制成导线,如此便完成芯片制作。因产品性能需求及成本考量,导线可分为铝工艺(以溅镀为主)和铜工艺(以电镀为主参见Damascene)。[2][3][4]主要的工艺技术可以分为以下几大类:黄光光刻、刻蚀、扩散、薄膜、平坦化制成、金属化制成。
IC由很多重叠的层组成,每层由影像技术定义,通常用不同的颜色表示。一些层标明在哪里不同的掺杂剂扩散进基层(成为扩散层),一些定义哪里额外的离子灌输(灌输层),一些定义导体(多晶硅或金属层),一些定义传导层之间的连接(过孔或接触层)。所有的组件由这些层的特定组合构成。
- 在一个自排列(CMOS)过程中,所有门层(多晶硅或金属)穿过扩散层的地方形成晶体管。
- 电阻结构,电阻结构的长宽比,结合表面电阻系数,决定电阻。
- 电容结构,由于尺寸限制,在IC上只能产生很小的电容。
- 更为少见的电感结构,可以制作芯片载电感或由回旋器模拟。
- 因为CMOS设备只引导电流在逻辑门之间转换,CMOS设备比双极型组件(如双极性晶体管)消耗的电流少很多,也是现在主流的组件。透过电路的设计,将多颗的晶体管管画在硅晶圆上,就可以画出不同作用的集成电路。
随机存取存储器是最常见类型的集成电路,所以密度最高的设备是存储器,但即使是微处理器上也有存储器。尽管结构非常复杂-几十年来芯片宽度一直减少-但集成电路的层依然比宽度薄很多。组件层的制作非常像照相过程。虽然可见光谱中的光波不能用来曝光组件层,因为他们太大了。高频光子(通常是紫外线)被用来创造每层的图案。因为每个特征都非常小,对于一个正在调试制造过程的过程工程师来说,电子显微镜是必要工具。
在使用自动测试设备(ATE)包装前,每个设备都要进行测试。测试过程称为晶圆测试或晶圆探通。晶圆被切割成矩形块,每个被称为晶片(“die”)。每个好的die被焊在“pads”上的铝线或金线,连接到封装内,pads通常在die的边上。封装之后,设备在晶圆探通中使用的相同或相似的ATE上进行终检。测试成本可以达到低成本产品的制造成本的25%,但是对于低产出,大型和/或高成本的设备,可以忽略不计。
在2005年,一个制造厂(通常称为半导体工厂,常简称fab,指fabrication facility)建设费用要超过10亿美元,因为大部分操作是自动化的。
封装
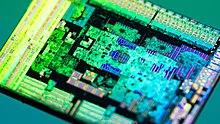
2019年AMD公司Ryzen5-3600处理器的集成电路未封装状态,内部结构可见。
最早的集成电路使用陶瓷扁平封装,这种封装很多年来因为可靠性和小尺寸继续被军方使用。商用电路封装很快转变到双列直插封装,简单来说,即开始是陶瓷,之后是塑料。1980年代,VLSI电路的针脚超过了DIP封装的应用限制,最后导致插针网格数组和芯片载体的出现。
表面贴着封装在1980年代初期出现,该年代后期开始流行。它的针脚使用更细的间距,引脚形状为海鸥翼型或J型。以Small-Outline Integrated Circuit(SOIC)为例,比相等的DIP面积少30-50%,厚度少70%。这种封装在两个长边有海鸥翼型引脚突出,引脚间距为0.05英寸。
Small-Outline Integrated Circuit(SOIC)和PLCC封装。1990年代,尽管PGA封装依然经常用于高端微处理器。PQFP和thin small-outline package(TSOP)成为高引脚数设备的通常封装。Intel和AMD的高端微处理器现在从PGA(Pine Grid Array)封装转到了平面网格阵列封装(Land Grid Array,LGA)封装。
球栅数组封装封装从1970年代开始出现,1990年代开发了比其他封装有更多管脚数的覆晶球栅数组封装封装。在FCBGA封装中,晶片被上下翻转(flipped)安装,通过与PCB相似的基层而不是线与封装上的焊球连接。FCBGA封装使得输入输出信号阵列(称为I/O区域)分布在整个芯片的表面,而不是限制于芯片的外围。如今的市场,封装也已经是独立出来的一环,封装的技术也会影响到产品的质量及良率。
世界著名集成电路生产厂家
以下是一些世界著名的集成电路(IC)生产厂家,它们在半导体和电子领域有着广泛的影响:
- 台积电 (TSMC):全球最大的纯晶圆代工厂,总部位于台湾。台积电主要生产逻辑芯片,为许多科技公司(如苹果、高通和英伟达)提供最先进的半导体工艺。
- 英特尔 (Intel):总部位于美国,专注于生产用于计算机、数据中心和物联网的处理器和其他集成电路。英特尔还涉足存储、通信等领域。
- 三星电子 (Samsung Electronics):韩国的全球性公司,拥有庞大的半导体部门。三星不仅生产自家设备所需的芯片,还为其他公司代工生产各种内存和逻辑芯片。
- 海力士 (SK Hynix):韩国的主要内存芯片制造商,全球领先的DRAM和NAND闪存生产商之一。
- 高通 (Qualcomm):总部位于美国,以生产移动设备的处理器(如Snapdragon芯片)著称,也是无线通信技术的先驱。
- 德州仪器 (Texas Instruments, TI):总部位于美国,生产各种类型的模拟和嵌入式处理器,是模拟芯片和电源管理芯片的市场领导者。
- 恩智浦半导体 (NXP Semiconductors):荷兰公司,专注于汽车、物联网和安全解决方案,提供广泛的嵌入式处理器和微控制器。
- 意法半导体 (STMicroelectronics):总部位于瑞士,产品涵盖汽车电子、工业电子、消费电子等领域,是全球领先的模拟IC和嵌入式处理器制造商。
- 美光科技 (Micron Technology):美国主要的内存芯片和存储解决方案制造商,产品涵盖DRAM、NAND闪存和SSD。
- 格芯 (GlobalFoundries):总部位于美国,为各种技术公司提供芯片代工服务,以稳定的28nm及以下工艺节点著称。
这些公司在集成电路领域各有专长,推动了半导体行业的技术进步和应用扩展。
